카이스트 반도체공학대학원
공동장비예약시스템
카이스트 반도체공학대학원의 공동 장비 정보를
종합적으로 제공하고 편리한 예약을 도와드립니다.

* 카이스트 소속 임직원/학부생과
등록된 외부인만 통합포털 로그인 사용가능





금속 (Cu, Al, Ni, Cr, Au 등) 시료에 열을 가해 녹인 후 evaporation 시켜 금속박막증착이 가능한 장비
예약 불가

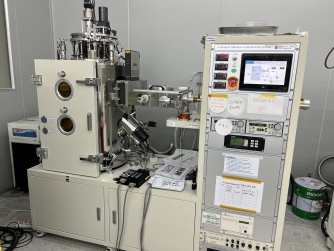






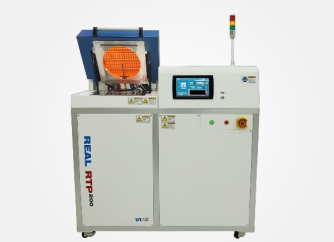
고온에서 열처리를 위한 장비

고온에서 열처리를 위한 장비


- 장비 위치 (실험실 명) - 나노에너지룸
- 장비 사진 - 금속현미경 사진 1 (첨부)
- 일반적 사양 - 컴퓨터와 연결된 100배까지 배율 조절이 가능한 금속 현미경입니다.
- 문제 발생시 연락할 장비담당자 이름과 이메일 - 김민수 / sidlilac@kaist.ac
- 기타 일반적으로 알야야 할 사용자 입장의 주의사항
1. 사용 후에는 반드시 광원을 종료해 주세요.
2. 렌즈가 오염되지 않도록 주의해 주세요.
3. 시편 스테이지가 오염되지 않도록 관리해 주세요.
< 예약 없이 바로 사용 가능함>
예약 불가

- 장비 위치 (실험실 명) - 공용장비실
- 장비 사진 - 금속현미경 사진 2 (첨부)
- 일반적 사양 - 컴퓨터와 연결된 100배까지 배율 조절이 가능한 금속 현미경입니다.
- 문제 발생시 연락할 장비담당자 이름과 이메일 - 김민수 / sidlilac@kaist.ac
- 기타 일반적으로 알야야 할 사용자 입장의 주의사항
1. 사용 후에는 반드시 광원을 종료해 주세요.
2. 렌즈가 오염되지 않도록 주의해 주세요.
3. 시편 스테이지가 오염되지 않도록 관리해 주세요.
예약 불가




<예약관련>
(1) 자율사용자 교육은 장비담당자에게 연락
(2) 최소 1시간 예약, 최대3시간 예약
(3) 24시간 예약 사용 가능.
(1) 파우더등 날리는 시료 및 부착이 단단하지 않은 carbon nanotube 및 nanowire 측정 금지.
(2) Vent할때 뚜껑이 아직 닫혀 있는데 과도하게 당겨서 열려고 하지 말 것
(3) Pumping할 때 살짝 뚜껑을 손으로 누르고 있는 상태에서 Pump 버튼을 누른 후 누르는 상태를 10초간 유지.
(4) Working distance를 좁힐 때 조금씩 좁히며, Pole piece에 닿지 않게 주의. (카메라 화면을 보면서 GoTo를 누른 후 pole piece에 닿을 것 같으면 바로 Stop 버튼을 누름)
(5) 전압과 전류를 한번에 과도하게 높이지 말고 점진적으로 높이거나 줄임.
(6) 종료 시 저배율로 하고 전압, 전류 낮춘 후 beam off함.
(7) 시료 수거 후 안전하게 (3)과 같이 Pumping하여 진공 잡고 퇴장함.
.

<사용 사항>
(1) ***해당 장비는 예약없이 사용을 바로 할 수 있음*** (사용자가 있을 경우 기다렸다가 사용함.)
(2) 조명은 on한 후 천천히 세기를 올리고, 끌 때도 조명 세기를 약하게 한 후 off함.
(3) 측정 종료 후 조명 끄는 것 잊이 말 것.
< 장비 사양>
(1) Objective lens : x4, x10, x20, x50, x100
(2) 영상 프로그램을 통해서 이미지 캡쳐 및 길일 측정 가능
(3) x50 objective lens의 경우 bright field 뿐아니라 Dark field 측정도 가능
(4) 480 nm, 550 nm 조명 필터 : 해당 빛 파장에 대한 형광이미징 가능
U-25Y48 filter : 480 nm 부근 파장을 입사광으로 사용
U-25IF550 filter : 550 nm 부근 파장을 입사광으로 사용
(5) 편광 특성 측정 가능
U-PO3 filter : linear polarizer 조명을 특정 편광으로 조사.
U-AN360-3 : analyzer 손으로 각도를 조절하여 해당 편광 특성 확인.
< 예약 없이 바로 사용 가능함>

<장비 사양>
.
1. Field: 8 tesla
2. Field direction: Vertical
3. Ramp time to full field : within 30min.
4. Temperature range: 1.5 to 300K
5. Temperature stability: ±10mK below 20K / ±100mK below 100K (over 10 min period)
6. Sample space diameter: 50mm
7. Total cooldown from warm : within 24 hours to 1.5K
8. Sample Holder: Demountable sample holder / Chip carrier types: LCC44x:44-pinLCCsocketnoESD
(x=H,appliedfieldnormaltosocket)orVertical(x=V,appliedfieldparalleltosocket)orientations
.
<사용자 주의 사항 및 자율사용 >
.
1. 실사용자가 장비 사용 요청을 하게 되면 3-4차례 정도 관리자와 함께 사용 후 자율 사용 권한을 부여하는 형태로 진행.
2. Probe에 장착 가능한 LCC44 chip carrier는 공용으로 제공하나 wirebonding은 실사용자가 직접 해야 함 (물리과나 KARA wirebonder 활용 및 Indium cold welding 등).
3. 기본 온도, 압력, 자기장을 변화시키는 Labview 코드는 장비 자율 사용 교육 하면서 제공 / 현재 공용 계측기가 없는 상황이기 때문에 측정 관련 계측기(adapter 및 cable 포함) 및 측정시 필요한 코드를 실사용자가 측정실에 가져와야 함.
단 wirebonding 및 측정 관련하여 사용 초기에 관리자들이 도움을 줄 수 있으나 이후에는 실사용자가 전적으로 모두 진행해야 함
.
<장비 교육 및 문제 발생시 연락할 장비 담당 학생 >
.
1. 황재하, jhhwang@kaist.ac.kr
2. 나형준, ibro6@kaist.ac.kr
3. 석용욱, seok5162@kaist.ac.kr


